
給大家說說芯片測試相關(guān)。1測試在芯片產(chǎn)業(yè)價(jià)值鏈上的位置如下面這個(gè)圖表,一顆芯片最終做到終端產(chǎn)品上,一般需要經(jīng)過芯片設(shè)計(jì)、晶圓制造、晶圓測試、封裝、成品測試、板級封裝等這些環(huán)節(jié)。在整個(gè)價(jià)值鏈中,芯片公司需要主導(dǎo)的環(huán)節(jié)主要是芯片設(shè)計(jì)和測試,其余的環(huán)節(jié)都可以由相應(yīng)的partner來主導(dǎo)或者完成。
芯片測試科普
給大家說說芯片測試相關(guān)。1測試在芯片產(chǎn)業(yè)價(jià)值鏈上的位置如下面這個(gè)圖表,一顆芯片最終做到終端產(chǎn)品上,一般需要經(jīng)過芯片設(shè)計(jì)、晶圓制造、晶圓測試、封裝、成品測試、板級封裝等這些環(huán)節(jié)。在整個(gè)價(jià)值鏈中,芯片公司需要主導(dǎo)的環(huán)節(jié)主要是芯片設(shè)計(jì)和測試,其余的環(huán)節(jié)都可以由相應(yīng)的partner來主導(dǎo)或者完成。 圖(1)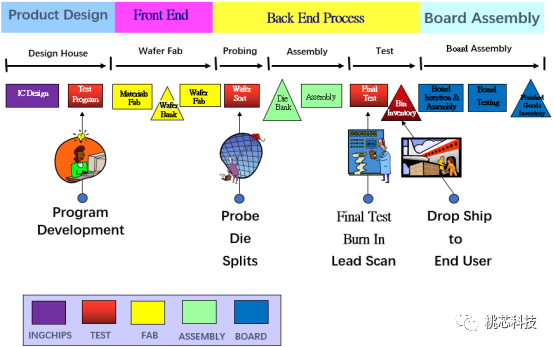 2測試如何體現(xiàn)在設(shè)計(jì)的過程中 下圖表示的是設(shè)計(jì)公司在進(jìn)行一個(gè)新的項(xiàng)目的時(shí)候的一般流程,從市場需求出發(fā),到產(chǎn)品tape out進(jìn)行制造,包含了系統(tǒng)設(shè)計(jì)、邏輯設(shè)計(jì)、電路設(shè)計(jì)、物理設(shè)計(jì),到最后開始投入制造。最下面一欄標(biāo)注了各個(gè)設(shè)計(jì)環(huán)節(jié)中對于測試的相關(guān)考慮,從測試架構(gòu)、測試邏輯設(shè)計(jì)、測試模式產(chǎn)生、到各種噪聲/延遲/失效模式綜合、進(jìn)而產(chǎn)生測試pattern,最后在制造完成后進(jìn)行測試,對測試數(shù)據(jù)進(jìn)行分析,從而分析失效模式,驗(yàn)證研發(fā)。所以,測試本身就是設(shè)計(jì),這個(gè)是需要在最初就設(shè)計(jì)好了的,對于設(shè)計(jì)公司來說,測試至關(guān)重要,不亞于電路設(shè)計(jì)本身。
2測試如何體現(xiàn)在設(shè)計(jì)的過程中 下圖表示的是設(shè)計(jì)公司在進(jìn)行一個(gè)新的項(xiàng)目的時(shí)候的一般流程,從市場需求出發(fā),到產(chǎn)品tape out進(jìn)行制造,包含了系統(tǒng)設(shè)計(jì)、邏輯設(shè)計(jì)、電路設(shè)計(jì)、物理設(shè)計(jì),到最后開始投入制造。最下面一欄標(biāo)注了各個(gè)設(shè)計(jì)環(huán)節(jié)中對于測試的相關(guān)考慮,從測試架構(gòu)、測試邏輯設(shè)計(jì)、測試模式產(chǎn)生、到各種噪聲/延遲/失效模式綜合、進(jìn)而產(chǎn)生測試pattern,最后在制造完成后進(jìn)行測試,對測試數(shù)據(jù)進(jìn)行分析,從而分析失效模式,驗(yàn)證研發(fā)。所以,測試本身就是設(shè)計(jì),這個(gè)是需要在最初就設(shè)計(jì)好了的,對于設(shè)計(jì)公司來說,測試至關(guān)重要,不亞于電路設(shè)計(jì)本身。  圖(2)設(shè)計(jì)公司主要目標(biāo)是根據(jù)市場需求來進(jìn)行芯片研發(fā),在整個(gè)設(shè)計(jì)過程中,需要一直考慮測試相關(guān)的問題,主要有下面幾個(gè)原因:1) 隨著芯片的復(fù)雜度越來越高,芯片內(nèi)部的模塊越來越多,制造工藝也是越來越先進(jìn),對應(yīng)的失效模式越來越多,而如何能完整有效地測試整個(gè)芯片,在設(shè)計(jì)過程中需要被考慮的比重越來越多。2) 設(shè)計(jì)、制造、甚至測試本身,都會帶來一定的失效,如何保證設(shè)計(jì)處理的芯片達(dá)到設(shè)計(jì)目標(biāo),如何保證制造出來的芯片達(dá)到要求的良率,如何確保測試本身的質(zhì)量和有效,從而提供給客戶符合產(chǎn)品規(guī)范的、質(zhì)量合格的產(chǎn)品,這些都要求必須在設(shè)計(jì)開始的第一時(shí)間就要考慮測試方案。3) 成本的考量。越早發(fā)現(xiàn)失效,越能減少無謂的浪費(fèi);設(shè)計(jì)和制造的冗余度越高,越能提供最終產(chǎn)品的良率;同時(shí),如果能得到更多的有意義的測試數(shù)據(jù),也能反過來提供給設(shè)計(jì)和制造端有用的信息,從而使得后者有效地分析失效模式,改善設(shè)計(jì)和制造良率。 3測試的各種
圖(2)設(shè)計(jì)公司主要目標(biāo)是根據(jù)市場需求來進(jìn)行芯片研發(fā),在整個(gè)設(shè)計(jì)過程中,需要一直考慮測試相關(guān)的問題,主要有下面幾個(gè)原因:1) 隨著芯片的復(fù)雜度越來越高,芯片內(nèi)部的模塊越來越多,制造工藝也是越來越先進(jìn),對應(yīng)的失效模式越來越多,而如何能完整有效地測試整個(gè)芯片,在設(shè)計(jì)過程中需要被考慮的比重越來越多。2) 設(shè)計(jì)、制造、甚至測試本身,都會帶來一定的失效,如何保證設(shè)計(jì)處理的芯片達(dá)到設(shè)計(jì)目標(biāo),如何保證制造出來的芯片達(dá)到要求的良率,如何確保測試本身的質(zhì)量和有效,從而提供給客戶符合產(chǎn)品規(guī)范的、質(zhì)量合格的產(chǎn)品,這些都要求必須在設(shè)計(jì)開始的第一時(shí)間就要考慮測試方案。3) 成本的考量。越早發(fā)現(xiàn)失效,越能減少無謂的浪費(fèi);設(shè)計(jì)和制造的冗余度越高,越能提供最終產(chǎn)品的良率;同時(shí),如果能得到更多的有意義的測試數(shù)據(jù),也能反過來提供給設(shè)計(jì)和制造端有用的信息,從而使得后者有效地分析失效模式,改善設(shè)計(jì)和制造良率。 3測試的各種
對于芯片來說,有兩種類型的測試,抽樣測試和生產(chǎn)全測。抽樣測試,比如設(shè)計(jì)過程中的驗(yàn)證測試,芯片可靠性測試,芯片特性測試等等,這些都是抽測,主要目的是為了驗(yàn)證芯片是否符合設(shè)計(jì)目標(biāo),比如驗(yàn)證測試就是從功能方面來驗(yàn)證是否符合設(shè)計(jì)目標(biāo),可靠性測試是確認(rèn)最終芯片的壽命以及是否對環(huán)境有一定的魯棒性,而特性測試測試驗(yàn)證設(shè)計(jì)的冗余度。這里我們主要想跟大家分享一下生產(chǎn)全測的測試,這種是需要100%全測的,這種測試就是把缺陷挑出來,分離壞品和好品的過程。這種測試在芯片的價(jià)值鏈中按照不同階段又分成晶圓測試和最終測試(FT,也叫封裝測試或者成品測試),就是上面圖(1)中的紅色部分。 測試相關(guān)的各種名詞:ATE-----------Automatic Test Equipment,自動化測試設(shè)備,是一個(gè)高性能計(jì)算機(jī)控制的設(shè)備的集合,可以實(shí)現(xiàn)自動化的測試。Tester---------測試機(jī),是由電子系統(tǒng)組成,這些系統(tǒng)產(chǎn)生信號,建立適當(dāng)?shù)臏y試模式,正確地按順序設(shè)置,然后使用它們來驅(qū)動芯片本身,并抓取芯片的輸出反饋,或者進(jìn)行記錄,或者和測試機(jī)中預(yù)期的反饋進(jìn)行比較,從而判斷好品和壞品。Test Program---測試程序,測試機(jī)通過執(zhí)行一組稱為測試程序的指令來控制測試硬件DUT-----------Device Under Test,等待測試的器件,我們統(tǒng)稱已經(jīng)放在測試系統(tǒng)中,等待測試的器件為DUT。 晶圓、單顆die和封裝的芯片----如下面圖(3)所示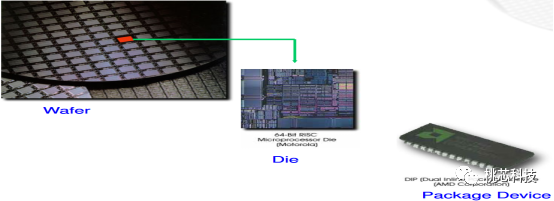 圖(3)Wafer就是晶圓,這個(gè)由Fab進(jìn)行生產(chǎn),上面規(guī)則地放著芯片(die),根據(jù)die的具體面積,一張晶圓上可以放數(shù)百數(shù)千甚至數(shù)萬顆芯片(die)。Package Device就是封裝好的芯片,根據(jù)最終應(yīng)用的需求,有很多種形式,這個(gè)部分由芯片產(chǎn)業(yè)價(jià)值鏈中的封裝工廠進(jìn)行完成。 測試系統(tǒng)的基本工作機(jī)制:
圖(3)Wafer就是晶圓,這個(gè)由Fab進(jìn)行生產(chǎn),上面規(guī)則地放著芯片(die),根據(jù)die的具體面積,一張晶圓上可以放數(shù)百數(shù)千甚至數(shù)萬顆芯片(die)。Package Device就是封裝好的芯片,根據(jù)最終應(yīng)用的需求,有很多種形式,這個(gè)部分由芯片產(chǎn)業(yè)價(jià)值鏈中的封裝工廠進(jìn)行完成。 測試系統(tǒng)的基本工作機(jī)制: 圖(4) 對測試機(jī)進(jìn)行編寫程序,從而使得測試機(jī)產(chǎn)生任何類型的信號,多個(gè)信號一起組成測試模式或測試向量,在時(shí)間軸的某一點(diǎn)上向DUT施加一個(gè)測試向量,將DUT產(chǎn)生的輸出反饋輸入測試機(jī)的儀器中測量其參數(shù),把測量結(jié)果與存儲在測試機(jī)中的“編程值”進(jìn)行比較,如果測量結(jié)果在可接受公差范圍內(nèi)匹配測試機(jī)中的“編程值”,那么這顆DUT就會被認(rèn)為是好品,反之則是壞品,按照其失效的種類進(jìn)行記錄。 晶圓測試(wafer test,或者CP-chip probering):就是在圖(3)中的晶圓上直接進(jìn)行測試,下面圖中就是一個(gè)完整的晶圓測試自動化系統(tǒng)。Prober--- 與Tester分離的一種機(jī)械設(shè)備,主要的作用是承載wafer,并且讓wafer內(nèi)的一顆die的每個(gè)bond pads都能連接到probe card的探針上,并且在測試后,移開之前的接觸,同時(shí)移動wafer,換另外的die再一次連接到probe card的探針上,并記錄每顆die的測試結(jié)果。
圖(4) 對測試機(jī)進(jìn)行編寫程序,從而使得測試機(jī)產(chǎn)生任何類型的信號,多個(gè)信號一起組成測試模式或測試向量,在時(shí)間軸的某一點(diǎn)上向DUT施加一個(gè)測試向量,將DUT產(chǎn)生的輸出反饋輸入測試機(jī)的儀器中測量其參數(shù),把測量結(jié)果與存儲在測試機(jī)中的“編程值”進(jìn)行比較,如果測量結(jié)果在可接受公差范圍內(nèi)匹配測試機(jī)中的“編程值”,那么這顆DUT就會被認(rèn)為是好品,反之則是壞品,按照其失效的種類進(jìn)行記錄。 晶圓測試(wafer test,或者CP-chip probering):就是在圖(3)中的晶圓上直接進(jìn)行測試,下面圖中就是一個(gè)完整的晶圓測試自動化系統(tǒng)。Prober--- 與Tester分離的一種機(jī)械設(shè)備,主要的作用是承載wafer,并且讓wafer內(nèi)的一顆die的每個(gè)bond pads都能連接到probe card的探針上,并且在測試后,移開之前的接觸,同時(shí)移動wafer,換另外的die再一次連接到probe card的探針上,并記錄每顆die的測試結(jié)果。











